박막 공정은 여러 층의 얇은 박막을 형성, 필요한 특성(절연, 도전, 활성 영역)을 구현한다.

박막 공정을 형성하는 주요 공정으로는 플라즈마 공정, 물리적 기상 증착(PVD), 스퍼터링(Sputtering), 화학적 기상 증착(CVD), 플라즈마 강화 화학적 기상 증착(PECVD), 원자층 증착(ALD) 등이 있다.
플라즈마 공정(Plasma Processing)

- 이혼화된 상태: 플라즈마는 높은 엔어지 때문에 전자들이 원자에서 분리되어 장롭게 움직이는 상태이다. 이온화된 전자와 양이온들이 존재하므로, 플라즈마는 전기를 잘 통하고 높은 반응성을 보인다.
- 전기적 중성: 플라즈마 내부는 전자와 이온이 함께 존재하여 전체적으로 전기적 중성 상태를 유지하려는 성질이 강하다. 그러나 외부 전압을 인가하면 특정 방향으로 이온과 전자가 이동할 수 있게 되어 제어가 가능하다.
- 이온화 과정: 플라즈마를 생성하기 위해서는 먼저 기체를 이온화해야한다. 이 과정에서 주로 고전압이나 고주파(RF) 전자기파를 가해 기체 내에서 전자들이 원자나 분자로부터 떨어져 나가 자유전자가 된다.
- 자유전자 가속: 플라즈마 챔버 내부에 전기장을 가하면 기존에 존재하던 극소수의 자유전자가 가속된다. 이 전자들이 가속되어 매우 빠른 속도로 기체 분자에 충돌하게 된다.
- 이온화 충돌: 가속된 전자가 기체 분자에 충돌하면, 기체 분자의 전자 중 하나를 튕겨내어 이온화가 발생한다. 이 과정으로 기체 분자는 양전하를 띠는 이온이 되고, 충돌로 튕겨나온 전자는 또 다른 자유전자로 존재하게 된다.
- 이온화 연쇄반응: 이온화된 전자와 이온들이 계속해서 다른 중성 분자와 충돌하면서 점점 더 많은 이온과 전자가 생성된다. 이러한 충돌이 반복되면 기체는 완전히 플라즈마 상태로 변하여 매우 높은 전도성과 반응성을 가진다.
- 전자의 가속과 플라즈마 유지: 플라즈마 상태를 유지하려면 지속적으로 전자를 가속해야한다. 이를 위해 고주파 전기장을 사용한다.
플라즈마는 물질의 제 4상태로, 반도체 공정에서는 주로 고에너지 이온을 생성해 박막 증착(Deposition) 및 식각(Etching)에 활용된다. 전자와 이온으로 구성된 플라즈마 상태에서는 가스가 고온에서 이온화되어 높은 에너지를 가지게 된다. 이러한 고에너지 이온을 이용하여 박막을 정밀하게 제어할 수 있다.
화학 기상 증착(CVD, Chemical Vapor Deposition)
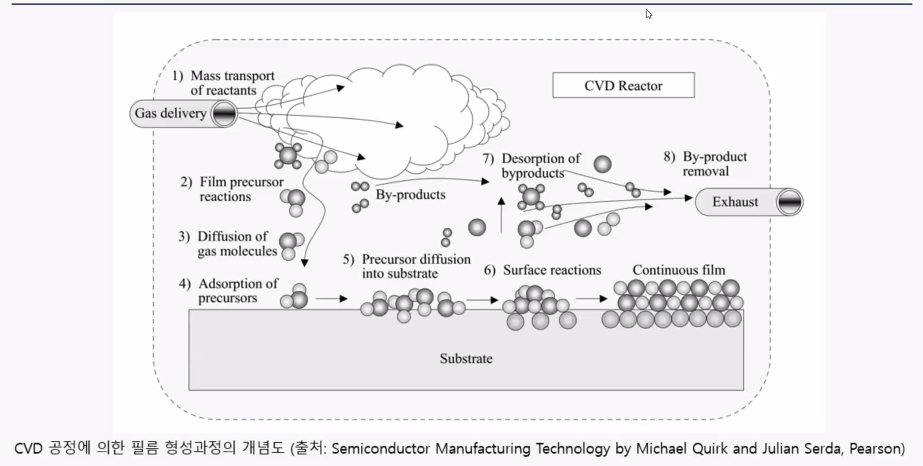
CVD는 주로 기체 화합물을 사용해 원하는 물질의 원자를 공급한다. 기체 화합물은 고온 환경에서 화학 반응을 일으키며, 기판 위에 박막을 형성하는 반응이 발생하면서 수 나노에 이르는 박막이 형성된다.
1) 기체공급: 반응 챔버 내에 원하는 물질의 원자를 포함한 반응 기체를 공급한다.
2) 기판 위 반응: 기체가 기판 표면에 도달해 고온 환경에서 화학반응을 일으킨다
3) 박막 형성: 반응 산물이 기판 표면에 고착해 박막을 형성하며 부산물은 기체 상태로 다시 챔버 밖으로 배출된다.
저압 CVD(LPCVD, Low Pressure CVD)
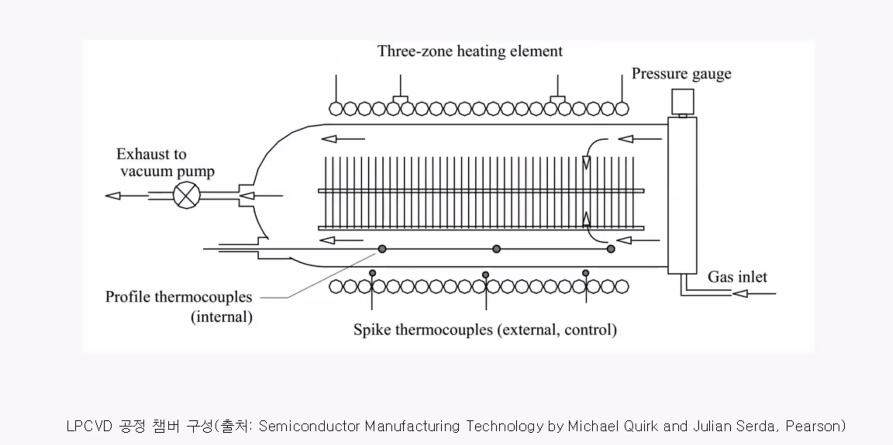
저압 CVD(LPCVD, Low Pressure CVD)는 진공 상태에서 저압으로 공정이 진행되므로 더욱 균일하고 미세한 박막을 형성할 수 있다.
플라즈마 강화 CVD(PECVD; Plasma-Enhanced CVD)
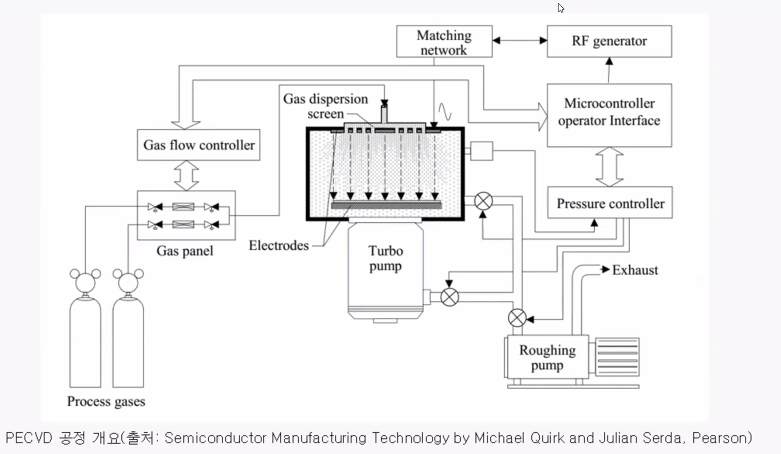
플라즈마 강화 CVD(PECVD; Plasma-Enhanced CVD)는 MOSFET, DRAM 등 반도체 소자에서 중요한 절연막을 형성하는데 널리 사용된다.
PECVD는 전기장을 이용해 기체 상태의 전구체를 고에너지 플라즈마로 이온화하고 그로부터 활성화된 화학반응을 통해 박막을 형성한다. 기판 온도를 낮추면서도 빠른 반응속도를 가지며 유기 및 비유기 막 형성에 사용된다.
1) 전구체 공급: PECVD 공정은 반응성 기체를 플라즈마 챔버에 주입하여 시작된다.
2) 플라즈마 생성: 전구체(반응성 기체)가 주입되면 고주파(RF) 또는 마이크로파(MW) 전압이 인가되어 플라즈마가 생성된다. 이떄 플라즈마는 전구체를 이온화하며 이 입자들은 높은 에너지를 지니고 표면 반응을 촉진한다.
3) 이온화와 화학적 반응: 생성된 플라즈마 내의 고에너지 입자들이 반응성 전구체와 충돌하면서 화학적 반응을 활성화 한다.
4) 박막 성장: 플라즈마 내 활성종들이 기판에 도달하면서 표면 반응을 일으켜 고체 상태의 박막을 형성한다.
원자층 증착(ALD, Atomic Layer Deposition)
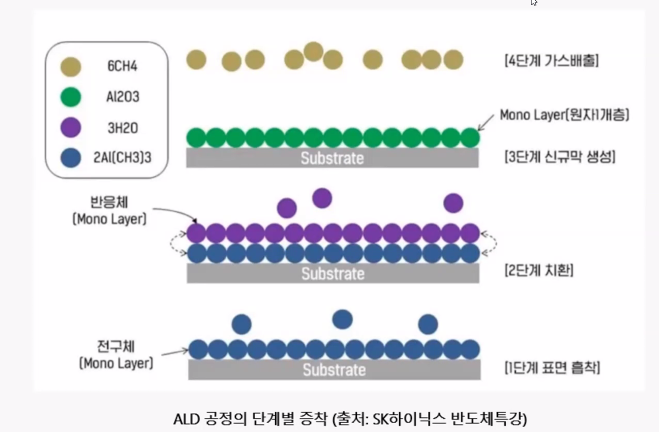
- ALD는 CVD의 한 형태로, 전구체 기체를 한 층씩 순차적으로 공급하여 박막을 형성하는 방식이다. 원자 단위의 층별 증착이 가능해, 미세한 두께 제어와 균일성을 극대화할 수 있다.
- ALD의 기본 원리는 두개 이상의 전구체를 순차적으로 사용하여 기판 표면에 반응을 일으키고, 이를 통해 한 층의 원자막을 증착시키는 방식이다. ALD는 자가 제어 반응(self-limiting reaction)원리를 이용해 박막 두께를 원자 수준에서 제어할 수 있다.
자가 제어 반응(Self-Limiting Reaction)
- ALD는 전구체와 기판 표면에서의 화학반응이 자가제어 반응으로 진행되어 기판 표면에 고르게 원자층을 형성한다.
- 이 자가 제어 반응 덕분에 공정 시간이 길어지거나 전구체 농도가 달라져도, 증착 두께에 영향을 주지 않고 한 층씩 정확하게 증착이 가능하다.
공정 단계
1) 전구체 A 주입
- 첫번째 전구체를 챔버에 주입하여 기판 표면에 흡착시킨다. 이 과정에서 전구체는 표면의 활성 결합부와 반응하여 흡착되며, 포화상태에 이르면 더이상 반응하지 않게 된다.(자가제어 반응)
2) 퍼지(Purge)
- 전구체 A가 흡착된 후, 반응하지 않은 잔여 전구체와 부산물을 제거하기 위해 불활성 기체(아르곤)을 사용하여 챔버를 퍼지한다. 이는 반응이 완료된 후 잔여 전구체나 부산물이 남아있지 않도록 한다.
3) 전구체 B 주입
- 기판 표면의 전구체 A와 반응을 일으켜 화합물을 형성한다. 이 과정에서 전구체 B와 기판에 흡착된 전구체 A가 결합하여 박막을 형성한다.
4) 퍼지(Purge)
- 두번째 퍼지 단계에선 반응이 완료된 후 남아있는 전구체 B와 부산물을 제거하여 챔버를 깨끗하게 한다. 이를 통해 다음 사이클에서도 동일한 두께와 품질을 유지할 수 있다.
이 4단계의 주기를 반복하여 박막의 두께를 조절한다. 한 주기에 형성되는 두께는 매우 얇기 때문에 주기 횟수를 통해 원하는 두께의 박막을 정확하게 형성할 수 있다.
'AI System Semiconductor' 카테고리의 다른 글
| 5.4. 반도체 패키징 공정 기술 (1) | 2025.01.07 |
|---|---|
| 5.3. 반도체 식각(Etching) 공정 기술 (0) | 2025.01.07 |
| 5.1. Photolithography, Extreme UV Lithography (0) | 2025.01.07 |
| 4.4. 반도체 소자 제조용 화학 물질 (0) | 2025.01.07 |
| 4.3 포토리소그래피(Photolithography) 기초 (0) | 2025.01.07 |